| |
| |
| |
| Silicon Die with 3-Rows of Bonding Pads |
Total I/O
Pads |
Perimeter
Rows |
Pad Size
µm |
Size (mm) |
Die
Thickness |
Metalization
over SiO2 |
Tray Qty |
Part Number |
Click Photo
to Enlarge |
| 380 |
3-Rows |
50SQ,90SQ
175x55 |
5x3.25mm
|
300,500,750µm |
Al 1.0µm |
144 |
TD380-5x3.2-BG300P
TD380-5x3.2-BG500P
TD380-5x3.2-BG750P |
 |
| 525 |
3-Rows |
50SQ,90SQ
175x55 |
5x6.5mm
|
300,500,750µm |
Al 1.0µm |
121 |
TD525-5x6.5-BG750P |
 |
| 670 |
3-Rows |
50SQ,90SQ
175x55 |
5x10mm
|
300,500,750µm |
Al 1.0µm |
TBA |
TD670-5x10-BG750P |
 |
| 815 |
3-Rows |
50SQ,90SQ
175x55 |
5x13mm
|
300,500,750µm |
Al 1.0µm |
TBA |
TD815-5x13-BG750P |
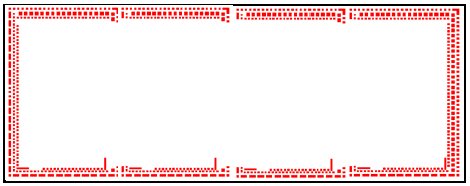 |
| 960 |
3-Rows |
50SQ,90SQ
175x55 |
5x16mm
|
300,500,750µm |
Al 1.0µm |
TBA |
TD960-5x16-BG750P |
 |
| 615 |
3-Rows |
50SQ,90SQ
175x55 |
10x3.25mm
|
300,500,750µm |
Al 1.0µm |
TBA |
TD615-10x3.2-BG750P |
 |
| 760 |
3-Rows |
50SQ,90SQ
175x55 |
10x6.5mm
|
300,500,750µm |
Al 1.0µm |
49 |
TD760-10x6.5-BG750P |
 |
| 905 |
3-Rows |
50SQ,90SQ
175x55 |
10x9.75mm
|
300,500,750µm |
Al 1.0µm |
49 |
TD905-10x10-BG750P |
 |
| 1050 |
3-Rows |
50SQ,90SQ
175x55 |
10x13mm
|
300,500,750µm |
Al 1.0µm |
25 |
TD1050-10x13-BG750P |
 |
| 1195 |
3-Rows |
50SQ,90SQ
175x55 |
10x16mm
|
300,500,750µm |
Al 1.0µm |
TBA |
TD1195-10x16-BG750P |
 |
| 1340 |
3-Rows |
50SQ,90SQ
175x55 |
10x19mm
|
300,500,750µm |
Al 1.0µm |
TBA |
TD1340-10x19-BG750P |
 |
| 995 |
3-Rows |
50SQ,90SQ
175x55 |
15x6.5mm
|
300,500,750µm |
Al 1.0µm |
TBA |
TD995-15x6.5-BG750P |
 |
| 1140 |
3-Rows |
50SQ,90SQ
175x55 |
15x9.75mm
|
300,500,750µm |
Al 1.0µm |
25 |
TD1140-15x10-BG750P |
 |
| 1285 |
3-Rows |
50SQ,90SQ
175x55 |
15x13mm
|
300,500,750µm |
Al 1.0µm |
25 |
TD1285-15x13-BG750P |
 |
| 1430 |
3-Rows |
50SQ,90SQ
175x55 |
15x16mm
|
300,500,750µm |
Al 1.0µm |
16 |
TD1430-15x16-BG750P |
 |
| 1575 |
3-Rows |
50SQ,90SQ
175x55 |
15x19mm
|
300,500,750µm |
Al 1.0µm |
16 |
TD1575-15x19-BG750P |
 |
| 1520 |
3-Rows |
50SQ,90SQ
175x55 |
20x13mm
|
300,500,750µm |
Al 1.0µm |
9 |
TD1520-20x13-BG750P |
 |
| 1665 |
3-Rows |
50SQ,90SQ
175x55 |
20x16mm
|
300,500,750µm |
Al 1.0µm |
9 |
TD1665-20x16-BG750P |
 |
| 1810 |
3-Rows |
50SQ,90SQ
175x55 |
20x19mm
|
300,500,750µm |
Al 1.0µm |
9 |
TD1810-20x19-BG750P |
 |
| 1950 |
3-Rows |
50SQ,90SQ
175x55 |
20x23mm
|
300,500,750µm |
Al 1.0µm |
9 |
TD1950-20x23-BG750P |
 |
| 1750 |
3-Rows |
50SQ,90SQ
175x55 |
25x13mm
|
300,500,750µm |
Al 1.0µm |
TBA |
TD1750-25x13-BG750P |
 |
| 1900 |
3-Rows |
50SQ,90SQ
175x55 |
25x16mm
|
300,500,750µm |
Al 1.0µm |
TBA |
TD1900-25x16-BG750P |
 |
| 2050 |
3-Rows |
50SQ,90SQ
175x55 |
25x19mm
|
300,500,750µm |
Al 1.0µm |
TBA |
TD2050-25x19-BG750P |
 |
| 2200 |
3-Rows |
50SQ,90SQ
175x55 |
25x23mm
|
300,500,750µm |
Al 1.0µm |
9 |
TD2200-25x23-BG750P |
 |
| 2300 |
3-Rows |
50SQ,90SQ
175x55 |
25x26mm
|
300,500,750µm |
Al 1.0µm |
9 |
TD2300-25x26-BG750P |
 |
 |
Back grind die thickness 250~750um.
Seed Layer Ti 300Å
Other Sizes available • Custom pad sizes and geometries available.
Packaging: 2" Waffle Pack (W) • 4" Waffle Pack (P) • Wafer Ring (NT12) • Tape and Reel (E) • JEDEC Tray (T)
Conductive Metallization available: Al, AlS, Al-Si-Cu, Al-Cu, Al-Si, Cu, Ru, Pd, Pt, Au, Ag, Ni, Co, a-Si, and NiSi
Refractory Metallization available: Ta, TaN, Ti, TiN, TiW, W, WN, WSi, Cr |
| |
| |
| JEDEC Moisture Sensitivity Level MSL-1 |
| |
About Dielectric Materials:
Silicon-dioxide insulator SiO2 k = 4.2 • Application: Gold and aluminum wire bonding
Low-k Dielectric k < 3.0 • Application: Copper wire bonding and ultra-fine pitch pads < 90nm
Competing Low-k process technologies:
1) Chemical vapor deposited (CVD) inorganic films such as carbon-doped oxides (SiOC) k~2.8
2) Spun-on dielectrics (SOD) - polymer organic films k 2.5~2.8
Challenge of bonding to pads with Low-k dielectrics:
Spongy dielectric underlayer layer causes top metallization layer to cup and deflect, thus lowering optimal bondability.
|
| Package Selector |
|
Part Numbering System |
| TD |
380 |
- |
5x3.2 |
- |
BG750 |
P |
| Die Type |
Nbr Bonding Pads |
|
Die Size (mm) |
|
Backgrind
Option |
Packaging
Options |
TD=Singulated Die
TDW = Sawn Wafer
TDWU = Unsawn Wafer |
380~2300
Other available |
|
Rectangular Example:
5x3.2= X5mm x Y3.2mm
Other sizes available |
|
Example:
BG750 = 750um (30mil)
BG500= 500um (20mil)
BG300 = 300um (12mils)
Blank = Undefined |
Single Die:
W = 2" Waffle Pack
P = 4" Waffle Pack
T = JEDEC Tray
E = Tape & Reel
Unsawn Wafer:
C = Cassette
J = Jar/Canister
Sawn Wafer:
NT8 = Dicing Tape 8" Ring
NT12 = Dicing Tape 12" Ring
UV8 = UV Tape 8" Ring
UV12 = UV Tape 12" Ring |
 |
| Aluminum Pads: 1st Layer: SiO2 - 3000Å • 2nd Layer: Ti - 300Å thick • 3rd Layer: Al - 1.0µm thick • ( 1.0µm = 10000Å = 10KÅ) |
| Copper and other pad platings available |
| |
| |
|
Die Daisy Chain Numbering System |
| 7 |
0 |
0380 |
| Variations |
Packaging |
I/O Pads |
Thickness
3=300um
5=500um
7=750um
Other Variations:
Plating
Materials
etc. |
Single Die:
0 = 4" Waffle Tray (P)
5 = 2" Waffle Tray (W)
2 = Tape & Reel (E)
Sawn Wafer Format:
3 = UV Tape & Ring ("U")
4 = Non-UV & Ring ("N")
Unsawn Wafer Format:
7 = Clam Shell, Jar, etc
To be Assigned:
1, 6, 8, 9 |
0380 = 380 pads
1575 = 1575 pads |
 |
| |
| |
| |
| |
|
|

TopLine Corporation
95 Highway 22 W
Milledgeville, GA 31061, USA
Toll Free USA/Canada (800) 776-9888
International: 1-478-451-5000 • Fax: 1-478-451-3000
Email: sales@topline.tv
©2013 TopLine. All Rights Reserved.
|
Home
|
|
|